Tecnologia “capped vias” per PCB HDI
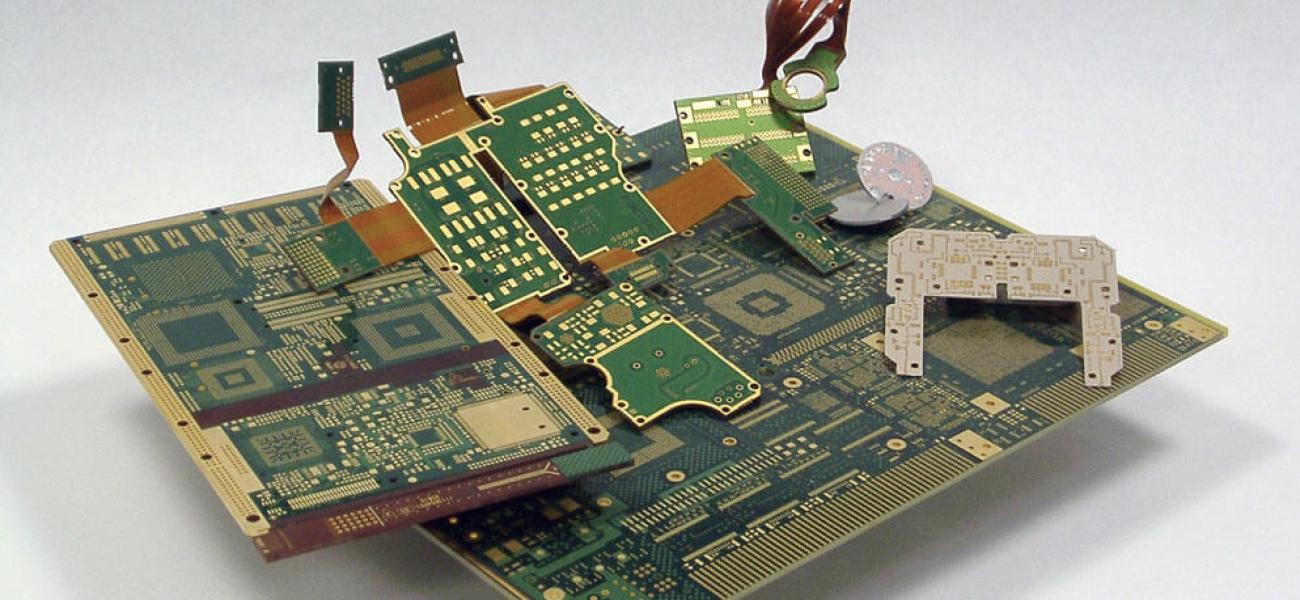
La tecnologia HDI ha richiesto l’adozione di nuove competenze tecniche, l’installazione di nuovi macchinari e l’implementazione degli annessi processi di produzione tra i quali quello di riempimento dei fori passanti e dei fori laser, necessari per la realizzazione di "filled and capped vias” tecnica anche nota come "plating over filled vias” ben descritta dalla norma IPC 4761 come Type VII.
La tecnologia capped vias con riempimento dei fori con resina ha lo scopo di aumentare la densità delle interconnessioni nel circuito stampato utilizzando gli spazi occupati dai fori passanti come punti di assemblaggio SMD. La tecnica prevede il riempimento dei fori dopo la placcatura degli stessi con spessori di rame alle pareti definiti con il cliente, normalmente >25µm.
Le resine utilizzate hanno specifiche proprietà di isolamento e di variazione dimensionale con le temperature, vengono trattate con il calore per la relativa polimerizzazione e conseguente indurimento, e, successivamente, vengono prima planarizzate e poi ricoperte da uno strato di rame con uno spessore di almeno 15µm.
Questa tecnica può essere applicata per la realizzazione di diverse tipologie di circuiti stampati e con molteplici varianti applicative che per questo motivo risultano in forte espansione:
- pads utilizzate per assemblaggio µBGA, "ball on via technology” ed SMD : "Via in Pad Assembly Technology”.
- pads utilizzate come test point "via in pad test technology”
- pads di dissipazione termica sotto i case dei componenti "heat managment”
- costruzione "SBU - sequential build up” con fori laser stacked su fori interrati trattati come capped vias Foto AA
Le operazioni fondamentali per il riempimento del foro con resina vengono eseguite in due fasi distinte: nella prima viene eseguito il riempimento dei fori a pressione variabile e vuoto per consentire il perfetto riempimento dei fori senza rischi di presenza di vuoti nella resina, mentre, nella seconda fase, viene eseguita una pulitura superficiale del pannello per eliminare la resina in eccesso facilitandone la successiva planarizzazione.
Qualunque sia la tecnologia finale prescelta, dopo la completa polimerizzazione, la resina viene rimossa tramite una azione meccanica di spazzolatura, detta planarizzazione, che può essere eseguita con specifiche macchine che lavorano con spazzole a tazza o con macchine a spazzolatura orizzontale.
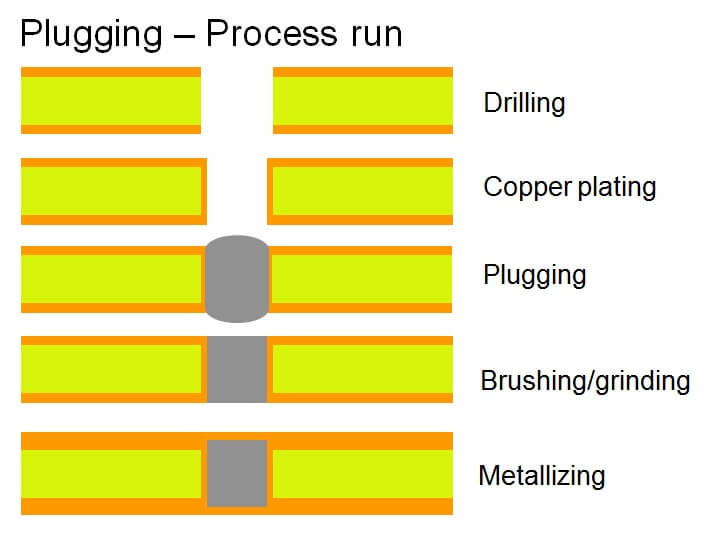
Il target è quello di rimuovere la resina in eccesso ed andare a creare sulla superficie un piano uniforme: tale operazione è propedeutica alla successiva sovramettallizzazione con rame dei capped vias. (inserire disegno allegato).